發光二極管(LED)失效分析(圖)
|
上傳人:蔡偉智 上傳時間: 2008-04-09 瀏覽次數: 4580 |
1 引言
和半導體器件一樣,發光二極管(LED)早期失效原因分析是可靠性工作的重要部分,是提高LED可靠性的積極主動的方法。LED失效分析步驟必須遵循先進行非破壞性、可逆、可重復的試驗,再做半破壞性、不可重復的試驗,最后進行破壞性試驗的原則。采用合適的分析方法,最大限度地防止把被分析器件(DUA)的真正失效因素、跡象丟失或引入新的失效因素,以期得到客觀的分析結論。針對LED所具有的光電性能、樹脂實心及透明封裝等特點,在LED早期失效分析過程中,已總結出一套行之有效的失效分析新方法。
2 LED失效分析方法
2.1 減薄樹脂光學透視法
在LED失效非破壞性分析技術中,目視檢驗是使用最方便、所需資源最少的方法,具有適當檢驗技能的人員無論在任何地方均能實施,所以它是最廣泛地用于進行非破壞檢驗失效LED的方法。除外觀缺陷外,還可以透過封裝樹脂觀察內部情況,對于高聚光效果的封裝,由于器件本身光學聚光效果的影響,往往看不清楚,因此在保持電性能未受破壞的條件下,可去除聚光部分,并減薄封裝樹脂,再進行拋光,這樣在顯微鏡下就很容易觀察LED芯片和封裝工藝的質量。諸如樹脂中是否存在氣泡或雜質;固晶和鍵合位置是否準確無誤;支架、芯片、樹脂是否發生色變以及芯片破裂等失效現象,都可以清楚地觀察到了。
2.2 半腐蝕解剖法
對于LED單燈,其兩根引腳是靠樹脂固定的,解剖時,如果將器件整體浸入酸液中,強酸腐蝕祛除樹脂后,芯片和支架引腳等就完全裸露出來,引腳失去樹脂的固定,芯片與引腳的連接受到破壞,這樣的解剖方法,只能分析DUA的芯片問題,而難于分析DUA引線連接方面的缺陷。因此我們采用半腐蝕解剖法,只將LEDDUA單燈頂部浸入酸液中,并精確控制腐蝕深度,去除LEDDUA單燈頂部的樹脂,保留底部樹脂,使芯片和支架引腳等完全裸露出來,完好保持引線連接情況,以便對DUA全面分析。圖1所示為半腐蝕解剖前后的φ5LED,可方便進行通電測試、觀察和分析等試驗。

在LED-DUA缺陷分析過程中,經常遇到器件初測參數異常,而解剖后取得的芯片進行探針點測,芯片參數又恢復正常,這時很難判斷異常現象是由于封裝鍵合不良導致,還是封裝樹脂應力過大所造成。采用半腐蝕解剖,保留底部樹脂,祛除了封裝樹脂應力的影響,又保持DUA內部引線連接,這樣就很容易確認造成失效的因素。
2.3 金相學分析法
金相學分析法是源于冶金工業的分析和生產控制手段,其實質是制備供分析樣品觀察用的典型截面,它可以獲得用其他分析方法所不能得到的有關結構和界面特征方面的現象[1]。LED的截面分析,是對LED-DUA失效分析的“最后手段”,此后一般無法再進行其他評估分析。它也是一種LED解剖
分析法,為了分析微小樣品,在一般試驗中,需要對分析樣品進行樹脂灌封,以便進行機械加工,再對所需要分析的界面進行刨削或切斷,然后經過研磨、拋光,獲得所要分析的界面。而對LED器件,有很多本身就是樹脂灌封器件,這樣只要選好界面,就可通過刨削、研磨、拋光等,獲得LED- DUA的典型截面。操作中,剖截面通常可用金剛砂紙研磨,當接近所關注的區域時,改用較細的金剛砂紙研磨或水磨,最后在細毛織物上用0.05μm的氧化鋁膏劑拋光。圖2為φ5白光LED側向典型截面,可清楚地看到其結構情況。
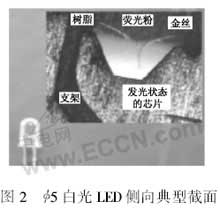
需要注意的是GaN基LED中的藍寶石襯底異常堅硬,由于目前尚未有較好的研磨方法,因此對這類的DUA還難以對芯片進行截面分析。
用戶名: 密碼:
