談論了好久的CSP,在行業不斷的爭議中漸漸成長起來,今天在線君不再想老生常談CSP未來會如何、今后會取代誰、是大趨勢什么的。因為最近在思考CSP時,發現一個很有意思的事,那就是CSP變了,變得中國化了。
眾所周知,CSP一出來,便以取代原有LED封裝的言論震驚四座,這也一度成為行業各大論壇爭論不休的話題,雖然至今也沒討論出什么結果,但是也留下了讓人印象深刻的一些言論。
現在看來,很多人猜對了開始,卻沒猜對結局。知道CSP會有一部分市場,也知道會從背光開始,但是大家一定沒有想到當初的CSP到了中國企業手里,竟然發生這么多的變化。
從CSP工藝說封裝
經過這么久的發展,我想大家對CSP不再是處于陌生的狀態了。目前實現CSP的白光工藝有多種方式,其中最理想的實現方式當屬Wafer層級的,可是目前很多企業卻不是這種工藝。這是因為此工藝實現的CSP,熒光膠只能覆蓋其LED芯片的表面,藍光會通過藍寶石從四周漏出,影響色空間分布的均勻性。
因為這樣,所以有企業考慮去除藍寶石,采用薄膜芯片工藝的方式,這樣雖減少藍光的泄露,但工藝成本太高,依然無法成為主流。這也就導致市面上主流技術路線仍然是采用切割芯片的技術。
正是因為切割技術占主流,傳統封裝企業才有機會,因為有著相似的熒光粉涂覆,測試、編帶等過程。
既然說到了封裝,那么目前市面上的CSP主要有以下三大主流封裝結構:
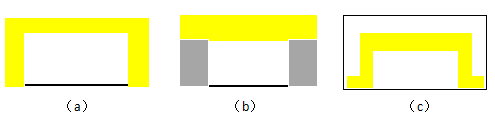
a. 采用硅膠熒光粉壓制而成,五面出光,光效高,但是頂部和四周的色溫一致性控制較差。
b. 采用周圍二氧化鈦保護再覆熒光膜,只有頂部一個發光面,光的一致性和指向性很好,但是損失了四周的光輸出,光效會偏低。
c. 采用熒光膜全覆蓋,再加透明硅膠固定成型,也是五面出光,光效高,光品質稍差。
除了封裝工藝本身的問題,CSP還有這些封裝問題
首先,過度依賴于倒裝芯片技術的提升,如芯片成本、光效、可靠性以及芯片耐ESD的擊穿能力;
其次,熒光粉涂覆工藝及其均勻性要求精度高,這直接影響色溫落Bin率及色空間分布;
第三,CSP免封裝器件由于體積小,對SMT貼片的精度要求更高;
第四,回流焊工藝將影響到焊點的空洞率,從而影響產品的散熱及可靠性;
第五,LED芯片與基板的熱膨脹系數差異較大容易產生應力,將直接影響芯片的信賴性;
因此,保證CSP免封裝器件在實現優異光效的同時,保證器件的信賴性是其在應用端發展的關鍵因素。
困難重重下,封裝企業干了啥?
雖然CSP存在著諸多問題,但是作為LED封裝的龍頭企業們,都在加速推動產品的發展,他們對csp花了很多心思,以下是在線君詢問一些企業的情況。
瑞豐
以往的單面出光 CSP僅僅考慮將側光圍擋,并未從結構設計上將這類光進行方向引導并提取出來。瑞豐針對單面出光 CSP產品結構進行改善,將白墻膠處理成有開口傾斜角度之后的結構。

這種結構能夠將原本會在白墻、熒光粉顆粒、芯片和膠體內反復反射、折射,最終被吸收轉換成熱量的熒光膠激發的水平方向部分光子,通過傾斜的白墻側壁導向出光面,這樣大幅提升了光效。
除了這個,還要提下瑞豐的FEMC產品,因為CSP的核心還是FC,而瑞豐把自己的EMC強項和FC結合在一起,開啟了封裝企業的新模式。這個發展正如德豪潤達莫慶偉博士所說,CSP不是洪水猛獸,它也不會一劍封喉,相反它的出現是一場LED產業的革新,也是一場挑戰,但同時更是新機遇!

FEMC結構簡圖
雷曼
雷曼使用的CSP器件采用熒光膠壓合的制備工藝制備而成,擁有器件無外加封膠結構,通過對熒光膠的改良與配置,調控CSP的側面與頂部的熒光層厚度,可以提高器件光的一致性,改善CSP器件在終端應用的光斑問題。
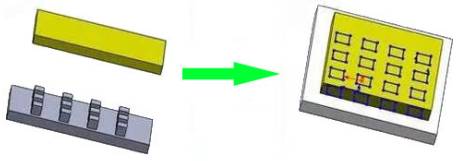
CSP器件的制備方式








